【推仔说新闻】新技术提升堪比工艺换代 细数Intel架构日(技术篇)
大家都知道,就在前段时间,Intel正式举办了新的架构日活动,在这次的活动上面,Intel可以说是化身“PPT”大厂,放出了非常多的新技术和产品信息。不光是大家期盼的下一代酷睿、还是研发了许久的Xe显卡都有所涉及。
不过考虑到Intel此次放出的东西太多,我还是将其拆分一下,本期新闻主要是跟大家聊一下,Intel在此次的架构日上面放出的各项技术。
SuperFin晶体管
大家都知道,目前主流的两大晶体管工艺分别是FinFET和GAA,而GAA是面向于3nm级别这种先进工艺的,台积电和三星都在尽力研发基于GAA的半导体工艺。
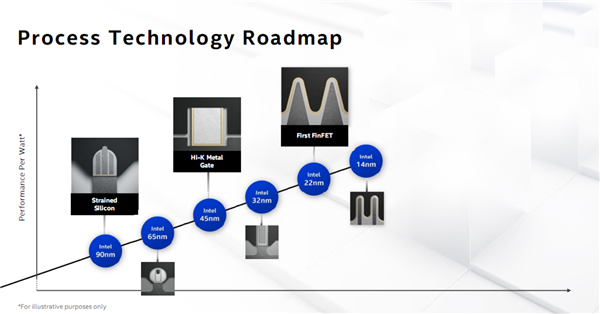
当然了由于众所周知的缘故,Intel和3nm还有这很远很远的距离,暂时不会考虑到。不过Intel在此次却提出了在10nm工艺上的SuperFin晶体管技术

简单来说Intel在目前的10nm工艺节点上将增强型FinFET晶体、Super MIM(金属-绝缘体-金属)电容器相结合,从而打造了全新的SuperFin。

Intel称,在SuperFin晶体管等各项技术的加持下,10nm工艺可以实现节点性能提升15%。
Hybrid Bonding(混合结合)

Intel此次推出的混合结合技术能够加速实现10微米及以下的凸点间距(Pitch)(Intel目前使用的3D Foveros立体封装技术仅能实现50微米左右的凸点间距)。

这也意味着该项技术可以带来更高的互连密度、更小更简单的电路、更大的带宽、更低的电容、更低的功耗。
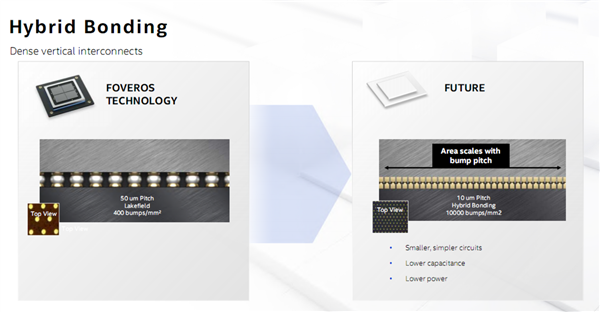
Intel表示这次推出的HybridBonding技术,可以取代目前主流封装技术中的thermocompressionbonding(热压结合)。
Intel称采用这项封装技术的测试芯片已在2020年第二季度流片,不过并没有透露将使用该技术的产品。
在推仔看来,正如我之前所说过的,是不是PPT还是叫基于产品来判断的,不管你Intel的会议上怎么说,最终都是要落地与产品的,TigerLake已经近在眼前了,SuperFin究竟能不能成为Intel在10nm工艺节点上的“救命稻草”我们马上就能知道了。
只不过另一个Hybrid Bonding技术,在我这看就有股PPT那味了,尤其是到了最后,Intel也并没有表示这项技术将用于何处,这给人一种满满的PPT感觉,会不会做着做着就被Intel自己放弃掉了都不好说。毕竟现在已经有了很先进且相对成熟的3D Foveros了,何必在封装模式上死扣,有着精力布局先进工艺不好么,真指望14nm++和10nm++打一辈子?


